어플라이드머티어리얼즈(AMAT, 이하 어플라이드)는 하이브리드본딩과 실리콘관통전극(TSV)을 통해 최첨단 패키징 성능을 향상시킬 수 있는 새로운 기술을 공개했다고 18일 밝혔다.
이 기술은 첨단 패키징의 일종이다. 반도체 업체들은 두 기술을 활용해 기존 2D를 뛰어넘는 2.5D, 3D 패키징을 구현하고 있다. 2.5D는 수평으로, 3D는 수직으로 개별 칩들을 연결해 반도체 성능과 수율을 높인다.
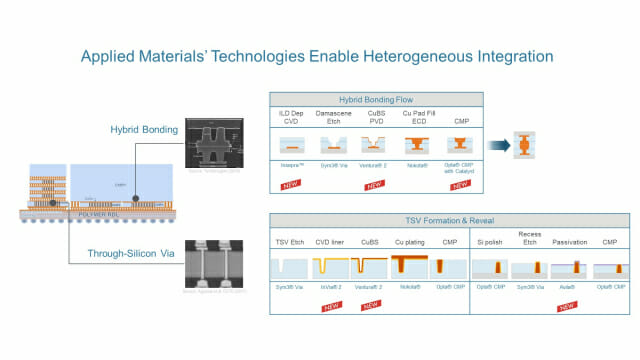
이들 기술은 칩렛과도 맞닿아 있다. 칩렛은 개별 칩을 이어 붙여 하나의 반도체로 만드는 기술이다. 더 넓은 의미에서 서로 다른 칩들을 연결한다는 뜻으로 이종접합이라고도 부른다.
어플라이드는 식각, 증착, 전기도금, 연마, 열처리 등 다양한 분야에서 이종접합의 성능을 높이기 위한 솔루션을 갖추고 있다.
어플라이드는 "성능, 전력, 비용을 동시에 개선할 수 없는 기존 2D 미세화의 한계를 극복하는 데 도움이 되는 이종접합 기술이 빠르게 성장하고 있다"며 "어플라이드의 최신 이종접합 솔루션은 2.5D 및 3D 구성에서 더 많은 트랜지스터와 배선을 패키징하는 첨단 기술을 발전시킨다"고 말했다.
일례로 어플라이드의 칩 투 웨이퍼(chip-to-wafer), 웨이퍼 투 웨이퍼(wafer-to-wafer) 하이브리드 본딩은 직접 구리-구리 결합을 사용해 칩을 연결함으로써, 결합된 소자가 단일 제품의 성능을 내도록 한다.
어플라이드가 출시한 인세프라(Insepra) 실리콘탄소질화물(SiCN) 증착 시스템은 업계 최고 수준의 유전체 본딩 강도를 자랑하며, 우수한 구리 확산 배리어 특성을 제공하는 새로운 SiCN 소재를 사용한다.
함께 출시된 카탈리스트(Catalyst) 화학적기계연마(CMP) 솔루션을 통해 고객은 후속 고온 열처리 단계에서 결합될 두 표면의 구리 소재를 의도적으로 오목하게 만드는 '디싱' 양을 제어할 수 있다. CMP 디싱은 구리 패드의 상단 표면에 원치 않는 금속 손실을 발생시켜 구리-구리 결합의 완성도와 강도를 떨어뜨리는 에어 갭을 유발할 수 있다.
또한 어플라이드는 더 높은 종횡비의 TSV를 구현하고, 유전체 및 금속 증착용 신기술을 선보였다.
관련기사
- AMAT, 지역아동 창의력 '과학교실' 3년 연속 지원2023.07.03
- 깊어지는 美·印 반도체 동맹…마이크론·AMAT 투자 '러시'2023.06.22
- AMAT, ESG 성과 담은 지속가능성 보고서 발표2023.06.21
- AMAT, 실리콘밸리 R&D시설 구축…40억달러 투자2023.05.23
프로듀서 인비아 2 화학기상증착(CVD) 시스템은 특수 인 시튜(in-situ) 증착 공정을 사용해 고종횡비 TSV에 탁월한 적합성을 제공한다. 원자층증착(ALD) 기술보다 높은 생산성을 제공함으로써 TSV의 웨이퍼당 비용을 절감시켜 도입이 더욱 확대될 수 있다.
엔듀라 벤튜라 2 물리기상증착(PVD) 시스템은 널리 채택된 기존 제품을 최대 20:1 종횡비를 가진 TSV 응용 분야로 확장한 제품이다. 현재 해당 시스템은 모든 첨단 파운드리 및 로직 칩 제조업체와 모든 주요 D램 생산업체가 사용 중이다.









