레이저쎌이 첨단 면레이저 기술로 일본 첨단 반도체 패키지기판 시장을 공략한다. 면레이저는 기존 열 방식 대비 미세 범프 형성 및 기판 안정성 확보에 유리해, 특히 AI 반도체용 기판에서 각광받을 것으로 기대된다.
12일 레이저쎌에 따르면 회사는 최근 일본 주요 반도체 기판기업과 FC-BGA용 레이저 장비에 대한 기술검증 3단계 테스트를 마무리했다.
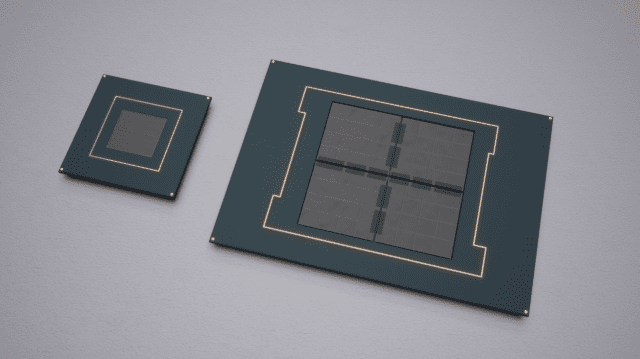
FC-BGA는 반도체 칩과 기판을 '플립칩 범프(칩을 뒤집는 방식)'로 연결하는 패키지기판이다. 기존 패키지에 주로 쓰이던 와이어 본딩 대비 전기적·열적 특성이 높다는 장점이 있다. 덕분에 AI 반도체 등 고성능 칩에서 수요가 높다.
현재 글로벌 FC-BGA 시장은 일본의 이비덴(Ibiden), 신코덴키(Shinko Electric)와 대만의 유니마이크론(Unimicron) 등 일부 기업이 70% 이상을 점유하고 있다. 특히 AI 서버용 고부가 FC-BGA 분야에서는 일본 기업들의 기술적 영향력이 절대적이라는 평가를 받고 있다.
기존 범핑 형성에 쓰이던 매스 리플로우 방식은 대량 양산 측면에서는 장점이 있지만, 열 스트레스·솔더 브리지·범핑 편차·기판의 휨 등 품질 이슈가 발생하기 쉽다는 한계가 있다.
이에 레이저쎌은 레이저 리플로우 기반 초정밀 범핑 형성 기술로 일본 FC-BGA 시장을 공략하고 있다. 해당 기술은 면레이저를 이용해 범핑 부위를 선택적으로 가열한다. 이를 통해 ▲불필요한 열 확산 최소화 ▲세계 최고 수준의 빔균일도를 통한 범핑 균일성 ▲기판의 휨(Warpage)을 최소화 등의 이점을 제공한다.
여기에 더해 레이저쎌은 범핑이 형성된 FC-BGA기판에서 불량 위치를 인공지능으로 정확히 찾아내고, 해당 불량만을 선택적으로 해결하는 '초정밀 인핸서드 리페어' 기술을 고도화했다.
관련기사
- 레이저쎌, '패널 패키징' 시장 공략..."면레이저 본딩 기술 독보적"2025.12.19
- 장덕현 삼성전기 사장 "FC-BGA 올 하반기 풀가동…증설 고려"2026.01.07
- LG이노텍, 대면적 FC-BGA·유리기판 등 차세대 기판 기술 공개2025.09.03
- 삼성전기, 글로벌 칩셋용 FC-BGA 라인 신설 추진2024.12.12
해당 기술은 ▲불량의 미세한 위치 자동 추적 ▲미세 영역의 선택적 가열을 통한 리페어 공정 ▲정상적인 범핑의 영역 영향의 최소화 달성 등 초고가 FC-BGA 기판을 폐기하지 않고 완성 수율을 극대화할 수 있도록 돕는다.
레이저쎌은 지난 3여년간 글로벌 기술표준을 주도하고 있는 일본 기판업체들과 해당 공정에 대한 기술력을 높여 왔다. 현재 해당 진행 단계는 지난해 말 최종 기술검증 3단계 테스트까지 완성된 상황이다.












