엔비디아가 출시를 앞둔 고성능 GPU의 라인업을 재정비하고, AI 데이터센터 시장을 적극 공략할 계획이다. 이에 따라 대만 주요 파운드리인 TSMC의 첨단 패키징 수요도 크게 늘어날 것으로 전망된다.
22일 시장조사업체 트렌드포스에 따르면 엔비디아는 최근 '블랙웰' 울트라 제품을 'B300' 시리즈로 브랜드를 변경했다.
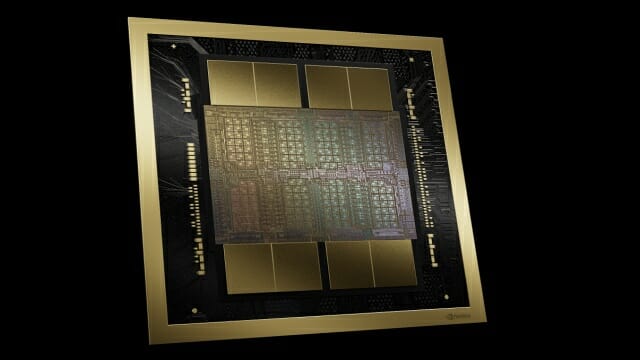
블랙웰은 엔비디아가 지난 3월 공개한 최신형 AI 반도체다. TSMC의 4나노미터(nm) 공정 및 첨단 패키징을 기반으로, 이전 세대(H100) 대비 데이터 연산 속도를 2.5배가량 높였다.
블랙웰 시리즈는 전력 소모량에 따라 B100, B200 등의 모델로 나뉜다. 두 모델은 HBM3E(5세대 고대역폭메모리) 8단 제품이 탑재된다. 나아가 엔비디아는 상위 모델인 B200 울트라를 설계하고, 여기에 HBM3E 12단을 적용하기로 한 바 있다.
이번 리브랜딩에 따라, B200 울트라는 B300으로 이름이 바뀌었다. '그레이스' CPU와 결합된 'GB200 울트라' 모델은 'GB300'으로 불린다.
기존 AI 반도체에서 성능을 일부 하향 조정한 'B200A 울트라'와 'GB200A 울트라' 역시 각각 'B300A', 'GB300A'로 변경됐다.
B300 시리즈는 내년 2분기와 3분기 사이에 출시될 것으로 예상된다. 기존 B200과 GB200 등은 올 4분기부터 내년 1분기 사이 양산이 시작될 전망이다.
트렌드포스는 "엔비디아는 당초 서버 고객사를 위해 B200A를 출시할 계획이었으나, 설계 과정에서 B300A로 전환해 성능을 하향 조정한 GPU의 수요가 예상보다 약하다는 것을 나타냈다"며 "또한 GB200A에서 GB300A로 전환하는 기업의 경우 초기 비용이 증가할 수 있다"고 설명했다.
또한 엔비디아의 고성능 GPU 출시는 TSMC의 'CoWoS' 패키징 수요를 크게 촉진할 것으로 분석된다. CoWoS는 TSMC가 자체 개발한 2.5D 패키징이다. 칩과 기판 사이에 인터포저라는 얇은 막을 삽입해, 패키징 면적을 줄이고 칩 간 연결성을 높인 것이 특징이다.
관련기사
- "엔비디아, 내년 HBM3E 물량 중 85% 이상 차지할 듯"2024.08.09
- 엔비디아, AI 칩 '블랙웰' 설계 결함 발견...공급 내년으로 지연2024.08.04
- TSMC, 첨단 패키징 생산능력 내년까지 폭증…수요 절반이 엔비디아2024.05.31
- SK하이닉스, TSMC 테크 행사서 'HBM·패키징 협력 관계' 강조2024.04.25
트렌드포스에 따르면 올해 CoWoS 수요는 전년 대비 10% 이상 증가할 것으로 예상된다.
트렌드포스는 "최근 변화에 비춰볼 때 엔비디아는 CoWoS-L 기술을 활용하는 북미 서버 고객사에 B300 및 GB300 제품을 공급하는 데 집중할 가능성이 높다"고 밝혔다. CoWoS-L는 로컬실리콘인터커넥트(LSI)라는 소형 인터포저를 활용하는 기술이다.












