HBM(고대역폭메모리)의 D램 적층 수가 점차 증가하는 추세에 따라 이를 위한 포커스링·디본딩 기술도 향후 많은 변화와 발전이 일어날 것으로 예상된다. 주요 메모리 제조업체와 관련 협력사들도 관련 기술에 대한 선제 개발에 이미 뛰어든 것으로 알려졌다.
22일 업계에 따르면 삼성전자, SK하이닉스 등 주요 메모리 제조업체는 차세대 HBM용 TSV 공정의 소재를 변경하는 방안을 검토하고 있다.
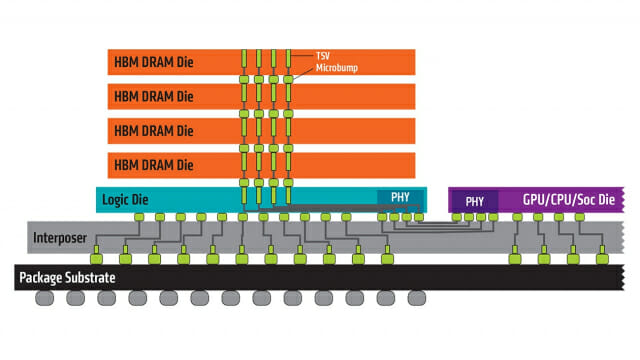
HBM은 여러 개의 D램을 수직으로 적층해 TSV(실리콘관통전극)로 연결한 차세대 메모리다. TSV는 층층이 쌓인 D램에 미세한 구멍(홀)을 뚫는 식각 공정을 진행한 뒤, 내부에 전도성 물질을 도금하는 공정을 뜻한다.
D램에 홀을 뚫기 위해서는 포커스링이라는 부품이 활용된다. 포커스링은 웨이퍼를 고정하면서 플라즈마 밀도를 균일하게 유지하고, 웨이퍼 측면의 오염을 방지하는 등의 역할을 맡고 있다. 기존에는 쿼츠(석영) 소재가 적용돼 왔다.
그러나 HBM이 현재 8단에서 12단·16단 등 보다 고적층 제품이 상용화되는 경우, 포커스링 소재도 쿼츠에서 실리콘 카바이드(SiC) 등으로 변경될 전망이다. SiC는 쿼츠 대비 고온 및 플라즈마에 대한 내성이 뛰어나다.
현재 전 세계 주요 식각 업체와 포커스링 제조업체가 HBM용 SiC 포커스링 개발을 추진 중이며, HBM 제조사인 삼성전자·SK하이닉스 등도 협력사 구성을 논의하고 있는 것으로 파악됐다.
업계 관계자는 "HBM 단수가 높게 쌓일수록 플라즈마 식각 환경에 노출되는 시간이 길어져, 관련 부품들의 소재 변경도 불가피한 것이 자명한 상황"이라며 "HBM 제조업체들도 이미 공급망 구성을 검토하고 있다"고 설명했다.
또 다른 관계자는 "HBM4(6세대 HBM) 등 차세대 제품에서 SiC 포커스링이 활용될 것으로 전망된다"며 "일부 부품업체도 이에 대한 준비에 분주한 것으로 안다"고 밝혔다.
HBM의 D램 적층 수가 16단·20단 이상에 도달하는 경우, '디본딩' 기술에도 변화가 일어날 것으로 관측된다.
HBM은 제한된 높이에 D램을 적층해야 하기 때문에 웨이퍼를 매우 얇게 만들어야 한다. 이 경우 워피지(휨) 현상이 발생할 수 있어, 웨이퍼를 받쳐주는 '캐리어 웨이퍼'가 임시로 부착된다. D램에 범프를 형성한 후에는 캐리어 웨이퍼를 다시 제거해야 하는 데, 이 공정을 디본딩이라고 부른다.
관련기사
- JEDEC "HBM4 규격 완성 초읽기"...업계 새 표준에 주목2024.07.17
- 마이크론 HBM 불량 이슈, 사실은..."성능 우수" vs "수율 불안" 엇갈려2024.07.12
- SK하이닉스 "자체 기술로 HBM 성공…경쟁사 출신 영입설 '사실무근'"2024.06.27
- 삼성·SK, 후공정 업계와 장비공급 논의…D램·HBM 수혜 본격화2024.06.24
현재 디본딩은 얇은 휠로 직접 웨이퍼와 캐리어 웨이퍼를 떼 내는 메커니컬(Mechanical peel-off) 기술이 활용된다. 그러나 향후에는 이를 레이저로 떼내는 기술이 채용될 예정으로, 복수의 장비업체들이 관련 장비 개발에 매진하고 있다.
업계 관계자는 "D램 웨이퍼 두께가 30마이크로미터 이하가 되면 메커니컬 디본딩으로는 크랙이 발생하는 등 문제가 생길 수 있다"며 "HBM이 20단으로 나아가면 D램 웨이퍼 두께가 25~28마이크로미터가량 돼야하기 때문에, 레이저를 활용할 수밖에 없다"고 말했다.












