삼성전자가 첨단 패키징 기술인 2.5D를 본격 상용화할 계획이다. 2.5D 패키징은 AI 반도체 제조의 핵심 요소 중 하나로, 삼성전자는 올 하반기 해당 사업에서 1천300억 원 이상의 매출을 올릴 수 있을 것으로 내다봤다.
20일 삼성전자는 경기 수원 컨벤션센터에서 '제55기 정기주주총회'를 열고 사업부문별 올해 경영전략에 대해 설명했다.
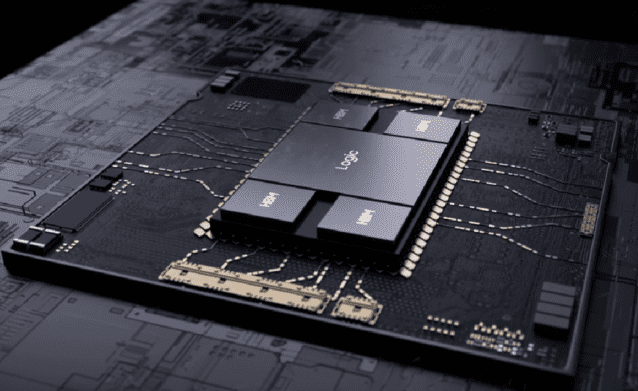
이날 경계현 삼성전자 DS부문 대표이사 사장은 첨단 패키징 사업과 관련한 질문에 대해 "삼성전자는 지난해 처음으로 AVP(어드밴스드 패키징) 사업팀을 만들어 운영을 시작했다"며 "투자 결과가 본격적으로 나오면서 올 하반기 2.5D 패키징에서 1억 달러 이상의 매출이 일어날 것"이라고 답했다.
2.5D 패키징은 넓은 기판 모양의 실리콘 인터포저 위에 반도체 다이(Die)를 수평 배치하는 기술이다. 기판만을 활용하는 기존 2D 패키징에 비해 회로를 더 밀도있게 연결할 수 있어, AI 가속기나 HPC(고성능컴퓨팅) 구현에 유리하다.
삼성전자는 이 2.5D 패키징에 '큐브'라는 자체 브랜드명을 붙이고 관련 기술을 개발해 왔다. 이외에도 삼성전자는 2.3D, 2.1D, 3D와 같은 첨단 패키징 기술도 개발하고 있다.
관련기사
- 경계현 삼성전자 "연말 LLM용 AI 칩 '마하1' 출시"2024.03.20
- 삼성전자, 올해 화두는 온디바이스 AI·HBM 주도권 회복2024.03.20
- 삼성전자 주총 "M&A 고민만 한다" 쓴소리에...한종희 "많이 진척돼 있어"2024.03.20
- 삼성전자, 55기 정기주총 개최...한종희 "주주에 9.8조 배당 지급"2024.03.20
AI 시대를 대비한 패널레벨패키지(PLP) 기술도 적용을 고려하고 있다. PLP는 원형 모양의 기존 웨이퍼보다 넓은 사각형 패널을 사용하는 기술이다. 더 넓은 다이의 칩을 생산하거나, 동일한 크기의 칩을 더 많이 생산하는 데 유리하다.
경계현 사장은 "AI 반도체 다이가 보통 600mm x 600mm이나 800mm x 800mm으로 크기 때문에, 패널레벨패키지와 같은 기술이 필요할 것이라고 생각하고 있다"며 "삼성전자도 개발 중이고, 고객사들과 협력도 하고 있다"고 설명했다.









