반도체 후공정 기업 네패스(대표 이병구)가 'FOWLP(팬아웃 웨이퍼 레벨 패키지)를 이용한 3D IC 핵심 소재 및 공정 기술 개발'을 완료했다.
네패스와 합동 연구단은 고성능 인공지능 반도체에 적용 가능한 3D 집적화 패키징 기술, 핵심 소재 및 테스트 솔루션 완성했다고 11일 밝혔다.
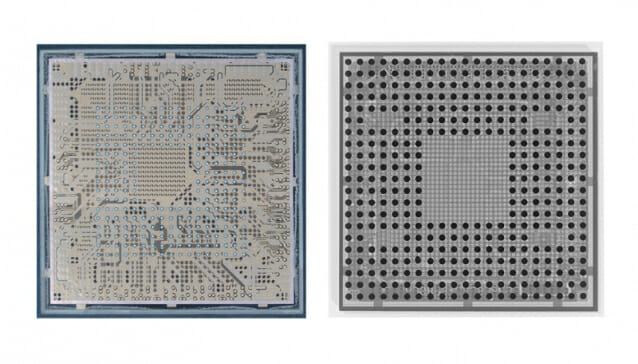
해당 과제는 네패스가 총괄을 맡아 2018년부터 약 5년간 진행됐다. 이번 연구는 첨단 반도체 핵심 기술 개발을 통해 대한민국 반도체 산업의 발전과 첨단 후공정 플랫폼 경쟁력을 확보한다는 목표로 마이크로프랜드, 켐이, 한국전자기술연구소, 서울테크노파크, 재료연구소, 서울과학기술대학교, 덕산하이메탈 등 다수의 기관이 컨소시엄에 참여해 시작됐다.
연구진은 AI, 로봇, IoT 등 응용 산업 전반 영역에서 수요가 급증하고 있는 고성능 반도체의 지능화, 저전력화, 경량화, 소형화를 구현하기 위한 반도체 패키징 공정·소재 기술을 집중적으로 연구했다.
국책과제에서 개발한 주요 기술은 ▲팬아웃 기반 고밀도 이종 적층 기술 ▲대면적 EMI 실딩(Shielding) 및 방열 EMC 몰딩(Molding) 패키지 기술 ▲PSPI중합 및 저온 경화형 절연막 감광재 소재 ▲파인 피치 대응용 프로브 카드(Probe Card) 개발 등이다.
이 기술을 바탕으로 반도체 폼팩터의 소형화와 박형화에 유리하고, 방열 특성과 전기적 특성이 우수한 고밀도 3D 패키지가 가능하게 된다. 팬아웃 기술 기반의 이종접합기술과 대용량 인터페이스 기술을 활용하면 인공지능 반도체, 엣지컴퓨팅, 클라우드서버 등의 분야에서 핵심 기술을 구체화해줄 것으로 기대된다.
관련기사
- 대만이 싹쓸이 한 반도체 후공정 산업...한국은 10년 뒤쳐져2023.02.22
- 반도체 후공정 살핀 이재용 "미래 투자 흔들려선 안 돼"2023.02.17
- 삼성·SK하이닉스, 소부장 상생 협력 한 목소리..."초일류 반도체 생태계 구축"2023.04.11
- "첨단 반도체 패키징 차세대 핵심 기술로 부상"2023.04.07
네패스는 본 과제를 통해 확보한 패키지 경쟁력으로 국내외 인공지능, 메모리 수요 업체와 사업화 기회를 발굴해 나간다는 방침이다.
김종헌 네패스 기술개발본부 부사장은 "이번 국책과제 수행을 통해 첨단 반도체 분야 신시장 확대에 기여할 것으로 기대한다"며 "앞으로도 네패스는 첨단 후공정 기술을 리딩하며 국내 산업 생태계 기반을 더욱 견고히 다져나갈 계획이다"고 밝혔다.









