삼성전자는 11일 고성능 반도체용 2.5D 패키징 솔루션 ‘H-Cube(Hybrid-Substrate Cube)’를 개발했다고 밝혔다.
패키징은 반도체 회로에 있는 전기선을 외부로 연결한 뒤 장기간 훼손되지 않도록 포장하는 공정이다. 2.5D 패키징 기술은 실리콘관통전극(TSV)으로 칩과 칩을 수직으로 연결하는 기술이다. 수평으로 배치된 여러 칩을 실리콘인터포저(Si Interposer)로 이어준다. 인터포저는 집적회로(IC) 칩과 인쇄회로기판(PCB) 회로 폭 차이를 완충시키는 역할을 한다.
삼성전자는 2.5D 패키징 기술의 밀도와 연결성이 기존 PCB로 칩을 연결하는 것보다 높다고 설명했다.
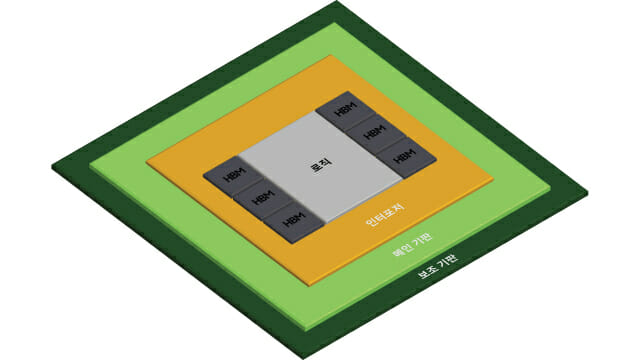
삼성전자는 데이터센터·인공지능(AI)·네트워크 등 시장에 맞는 반도체를 다양한 포장으로 제공하겠다고 공언했다. H-Cube는 주로 고성능컴퓨팅(HPC), 데이터센터, 네트워크용 고사양 반도체에 쓰인다.
삼성전자는 실리콘인터포저 위에 중앙처리장치(CPU)와 그래픽처리장치(GPU) 등 로직(Logic)과 고대역폭메모리(HBM)를 배치했다. H-Cube에 HBM을 6개 이상 실을 수 있다. HBM은 데이터를 읽고 쓰는 속도에 따라 HBM, HBM2, HBM2E, HBM3 등으로 나뉜다.
H-Cube는 주요 기판 아래 보조 기판을 더 쓰는 2단 하이브리드 패키징 구조다. 삼성전자는 주요 기판과 보조 기판을 전기로 연결하는 솔더볼(Solder ball) 간격을 기존보다 35% 좁혀 기판 크기를 줄였다고 강조했다.
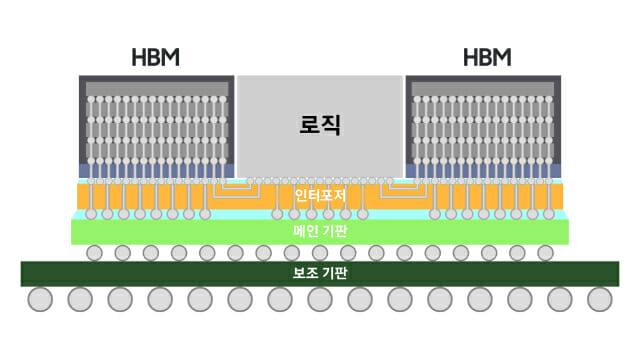
또 여러 로직과 HBM을 쌓으면서도 칩에 전원을 안정적으로 공급하고 신호가 손실되거나 왜곡되지 않도록 칩 분석 기술도 적용했다.
관련기사
- 삼성전자, 인간 뇌 닮은 반도체 비전 제시2021.09.26
- LG이노텍, 세계 최고 14.8kG 자석 성능 ‘친환경 마그넷’ 개발2021.09.13
- 삼성전자, 테라헤르츠 대역서 6G 통신 시연 성공2021.06.16
- 삼성, 차세대 반도체 패키지 'I-Cube4' 기술 개발2021.05.06
강문수 삼성전자 파운드리사업부 전무는 “H-Cube는 삼성전자와 앰코테크놀로지, 삼성전기가 오래 협력한 결과”라며 “많은 칩을 집적해야 하는 고사양 반도체에 알맞다”고 말했다.
김진영 앰코테크놀로지 기술연구소 상무는 “고성능컴퓨팅·AI 시장에서 요구되는 반도체 집적 기술을 구현했다”며 “반도체 위탁생산(파운드리) 회사와 반도체 패키징·시험 전문 업체(OSAT)가 함께 성공한 데 의미가 있다”고 자평했다.









