삼성전자가 내년 출시 예정인 6세대 고대역폭메모리(HBM4)에 맞춤형(커스터마이징) 서비스를 강화한다고 강조했다.
삼성전자는 메모리, 파운드리, 패키징을 모두 수행할 수 있는 종합반도체(IDM) 기업이라는 장점을 앞세우고 있다. 이를 통해 경쟁사와 HBM 기술에서 차별화를 둔다는 목표다. HBM은 여러 개 D램을 수직으로 연결해 기존 D램보다 데이터 처리 속도를 대폭 끌어올린 고성능 제품이다.
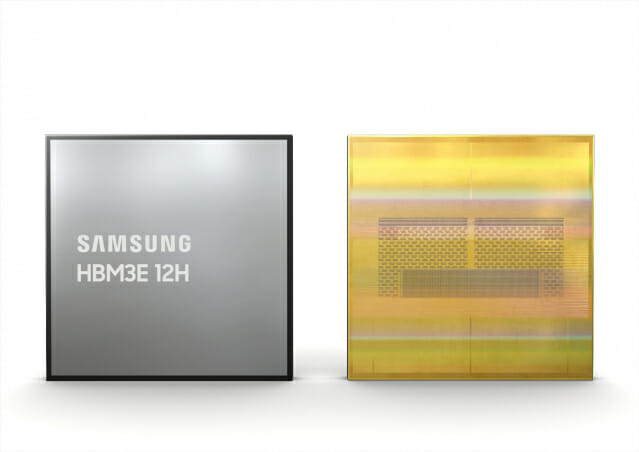
삼성전자는 9일 삼성동 코엑스에서 '삼성 파운드리 포럼'과 '세이프 포럼(SAFE) 2024'를 개최하고 AI를 주제로 향후 지원 계획을 발표했다.
이날 'AI 솔루션' 세션에서 최장석 메모리사업부 신사업기획팀장 부사장은 "HBM4는 HBM3 대비 성능이 대폭 향상됐다"라며 "48GB(기가바이트) 용량까지 확대해 내년 생산목표로 개발 중이다"고 밝혔다.
삼성전자는 HBM3E까지 MOSFET 공정을 적용했다면, HBM4부터 핀펫(FinFET) 공정을 적용을 긍정적으로 검토 중이다. 이에 따라 HBM4는 MOSFET 적용 대비 속도가 200% 빠르고, 면적은 70% 줄어들며, 성능은 50% 이상 향상된다고 밝혔다. 삼성전자가 HBM4 스펙에 대해 밝힌 것은 이번이 처음이다.
최 부사장은 "HBM 아키텍처에도 큰 변화가 오고 있다. 많은 고객들은 기존의 범용성 보다 맞춤형 최적화를 지향하고 있다"라며 "한가지 예로 HBM D램과 고객맞춤용 로직 칩의 3D 형태 적층은 전력과 면접을 크게 줄일 수 있고, 범용 HBM의 인터포저와 수많은 입출력(I/O)으로 인한 성능 확장에 대한 장벽을 제거할 것"이라고 설명했다.
그는 이어 "HBM은 성능과 용량뿐 아니라 전력과 열효율성도 간과할 수 없다. 이를 위해서 16단 HBM4는 NCF(비전도성접착필름) 조립 기술 외에도 HCB(하이브리드 본딩) 기술 등 여러 최첨단 패키징 기술뿐만 아니라 신규 공정까지 다양한 새로운 기술을 적절히 구현하는 것이 필수적이며 삼성은 계획된 일정에 맞춰서 준비 중이다"고 덧붙였다.
하이브리드 본딩은 반도체(다이) 위아래를 구리로 직접 연결하기 때문에 신호 전송 속도를 비약적으로 높일 수 있으며, HBM 높이도 줄일 수 있다.
관련기사
- 삼성전자 "2나노 가속기 수주...국내 DSP와 협력 강화"2024.07.09
- 삼성전자, 차세대 메모리 테스터 도입...엑시콘·네오셈에 '러브콜'2024.07.08
- '깜짝 실적' 삼성전자, 年매출 2년만 300兆 이상 전망2024.07.05
- 삼성전자, 'HBM 개발팀' 신설…전영현 체제서 첫 조직개편2024.07.04
최 부사장은 "수십 년간 삼성은 메모리 기술 혁신에 전념하며 끊임없이 진화했고, 지난 30년 동안 크고 작은 수많은 역경 속에서도 굳건히 리더십을 유지할 수 있었다"라며 "현재 큰 변화가 불고 있는 인공지능 시대에 경쟁력 있는 리더십을 지속해서 유지하겠다"고 전했다.
한편, 삼성전자는 HBM4 기술 개발을 강화한다는 방침이다. 삼성전자 디바이스솔루션(DS)부문은 HBM 개발팀 신설을 골자로 하는 조직개편을 단행했다. 전영현 부회장이 DS부문장에 취임한 지 한 달여 만이다. 신임 HBM 개발팀장에는 손영수 부사장이 선임됐다.












