정부가 반도체 첨단패키징 초격차 기술확보를 목표로 2744억원 규모로 연구개발(R&D) 사업을 추진한다. 이를 통해 고대역폭메모리(HBM), 모바일 애플리케이션 프로세서(AP) 등 첨단반도체의 핵심기술로 주목받고 있는 패키징의 국내 기술 경쟁력을 강화한다는 목표다.
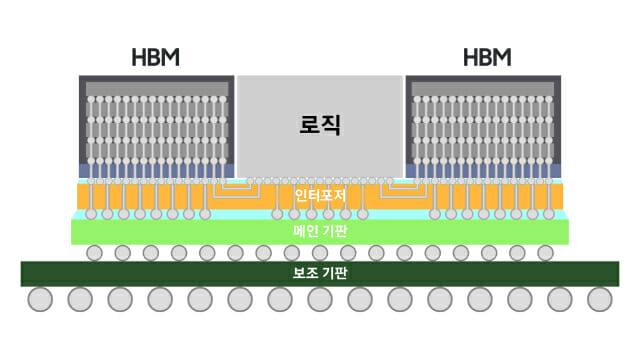
산업통상자원부는 26일 국가연구개발사업평가 총괄위원회에서 '반도체 첨단 패키징 선도기술 개발 사업'이 총사업비 2744억원 규모로 예비타당성 조사를 통과했다고 밝혔다. 사업비는 내년부터 2031년까지 총 7년간 지원된다.
첨단패키징은 지털 전환에 따른 고성능·다기능 반도체 수요증가에 따라 미세 공정의 기술적 한계 극복을 위한 핵심 기술로 첨단패키징 부상했다. 시장조사업체 욜디벨롭먼트에 따르면 첨단패키징은 2022년 443억 달러에서 2028년 786억 달러로 연평균 10% 성장할 전망이다.
이 가운데 우리 기업이 취약한 후공정 분야의 첨단패키징 기술을 선점해 글로벌 반도체 공급망 내 선도적인 지위 공고화 필요성이 대두되면서 이번 정부 R&D 사업이 추진됐다.
특히 칩렛(chiplet), 재배선 인터포저, 3D 패키징 등 차세대 패키지 핵심 기술 확보를 통해 고부가 시스템 반도체 소재, 공정, 장비 분야에서 시장 경쟁력을 확보하는 것을 목표로 한다.
관련기사
- TSMC, 첨단 패키징 생산능력 내년까지 폭증…수요 절반이 엔비디아2024.05.31
- 네패스, AI 반도체용 패키징 기술 'PoP' 상용화 추진2024.05.20
- 반도체 인력 확보 경쟁...삼성·SK 이어 현대차 가세2024.06.25
- SEMI "세계 반도체 생산능력, 올해 6%·내년 7% 성장할 것"2024.06.24
정부는 AI반도체, 화합물반도체 지원 등과 더불어 변화하는 첨단패키징의 적기 지원을 위해 ▲칩렛, 3D 패키징 등 차세대 중점기술 확보를 위한 첨단 선도 기술개발 ▲2.5D, 팬아웃(Fan-out) 등 고부가 모듈 구현을 위한 핵심 소부장, 검사 및 테스트 기술개발 ▲글로벌 첨단기술과 인프라를 보유한 기관과의 협업을 통한 수요 기술개발 등을 추진한다.
산업부는 "패키징 공정 기술과 이와 연관된 측정 검사 · 테스트 기술은 물론 소재, 부품, 장비 공급망을 내재화해 국가 전략 자산을 확보하겠다"라며 "기업의 글로벌 시장진출을 촉진하고, 국내 반도체 공급망 안정성을 강화하는데 기여할 것으로 기대한다"고 전했다.