네패스는 지난달 28일부터 31일(현지 시각)까지 미국 콜로라도주 덴버에서 열린 제74회 전자부품기술학회(ECTC)에서 팬아웃 기반 RDL 인터포저 기술을 선보였다고 3일 밝혔다.
네패스는 행사 이튿날인 29일, 미래 패키지 재료 기술의 열기계적 응력 및 신뢰성 분석 세션 에서 ‘팬아웃 RDL 인터포저와 실리콘 브릿지 기술을 기반으로 한 싱글 및 멀티 NPU 칩렛 이종 접합 패키징’이라는 주제의 논문과 함께 첨단 패키징 기술 현황을 공유했다.
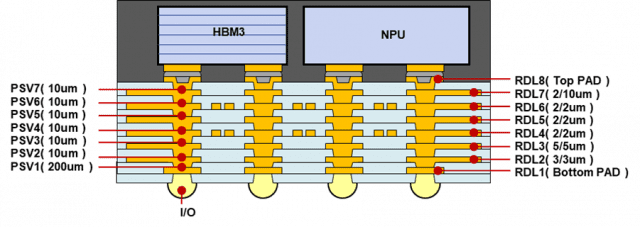
해당 기술은 인터포저 위에 여러 칩을 수직∙수평으로 연결하는 칩렛 패키징을 실리콘(Si) 인터포저 대신 팬아웃 공정 기반의 재배선(RDL) 인터포저로 구현한 것이 특징이다. 인공지능 반도체 수요 증가에 따라 칩렛 패키징 기술이 주요 화두인 가운데 우수한 전기적 특성 및 생산 효율성, 제조 비용 절감 등의 장점으로 현장 참가자들의 높은 관심을 받았다.
특히 이번 ECTC에서는 세계적으로 6 레이어 RDL 인터포저 기술이 일반적인 상황에서 기존보다 2 레이어를 더 쌓은 8 레이어 RDL 인터포저 기술을 개발 및 공유했다.
이는 과거 기판(Substrate)이 필요한 구조에서 기판이 필요 없는 구조가 됐다는 점에서 의미가 있다. 즉 기존의 경우 RDL 인터포저 제작 및 칩 접착과 몰딩 등의 공정 이후에 기판(Substrate) 위에 추가적으로 플립칩 공정을 진행해야 한다.
관련기사
- 네패스, AI 반도체용 패키징 기술 'PoP' 상용화 추진2024.05.20
- 네패스, 美 고객사 'AI반도체용 PMIC' 대량 수주2024.04.15
- 네패스, 자체 개발한 도금액 HBM 공정에 양산 적용2024.04.04
- 네패스, 칩렛 기반 AI반도체 개발에 지멘스 솔루션 도입2024.03.07
그러나 8 레이어 공정은 기판 위에 플립칩 공정이 필요 없어지면서 별도 기판없이 패키징이 가능해 전체 패키지 사이즈를 줄일 수 있다. 또한 공정이 간소화되면서 공정 효율성이 높아지고 복잡했던 기판과의 전기적 연결이 간결해지면서 우수한 전기적 특성 구현이 가능하게 되었다.
네패스 관계자는 “RDL 인터포저는 다양한 칩들을 연결하는데 적합한 솔루션으로 앞으로 시장 성장 잠재력이 매우 큰 추론용 인공지능의 엣지 컴퓨팅 분야 등에서 폭넓게 활용될 것으로 예상된다”며 “향후 네트워크 강화 및 고객사 기술 협력을 통해 상용화에 적극 나서 글로벌 반도체 패키지 경쟁력을 확보해 나갈 계획”이라고 밝혔다.












