해외 주요 반도체 장비업체들이 HBM(고대역폭메모리)용 하이브리드 본더 매출 확대에 나설 전망이다. 베시(BESI)는 올 하반기 HBM4용 장비 수주 확대를, ASMPT는 올 3분기 신규 장비의 고객사 출하를 앞두고 있다.
HBM용 하이브리드 본딩은 아직 연구개발(R&D) 단계에 있는 기술로, 삼성전자·SK하이닉스·마이크론 등 주요 메모리 기업이 모두 시제품 제작을 진행하고 있다. 이에 국내 한미반도체·한화세미텍 등도 제품 개발에 적극 나서는 추세다.
25일 업계에 따르면 세계 주요 반도체 후공정 장비기업들은 올 하반기 HBM용 하이브리드 본딩 장비 사업을 확대할 것으로 예상된다.
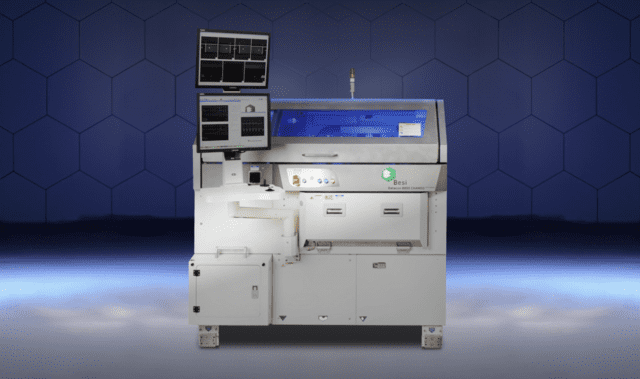
네덜란드 장비 기업 베시는 지난 24일(현지시간) 2025년 2분기 실적발표를 통해 올 하반기 하이브리드 본딩 등 첨단 패키징 장비의 견조한 수요로 실적이 개선될 것으로 내다봤다.
베시는 "고객사들이 2026~2027년 신제품 출시를 위한 기술 로드맵을 추진하면서, 고급 로직 및 HBM4 응용 분야에서 하이브리드 본딩 시스템 수주가 전년 동기 및 전반기 대비 크게 증가할 것으로 예상된다"고 밝혔다.
싱가포르에 본사를 둔 ASMPT도 지난 23일 2분기 실적발표에서 차세대 제품 상용화 계획이 순조롭게 진행되고 있음을 시사했다.
ASMPT는 "당사의 2세대 하이브리드 본더는 정밀도, 설치 면적, 시간당 처리량 측면에서 경쟁력 있는 성능을 제공한다"며 "올 3분기 중 HBM 고객사에 이 2세대 장비를 출하할 예정"이라고 밝혔다. 앞서 ASMPT는 지난해 HBM용 하이브리드 본더를 첫 수주해, 올해 중반 납품할 예정이라고 공지한 바 있다.
이들 기업이 HBM용 하이브리드 본더 공급을 확대할 수 있는 배경은 삼성전자·SK하이닉스·마이크론 등 메모리 기업들의 적극적인 연구개발(R&D) 덕분이다.
현재 HBM은 각 D램 사이에 미세한 범프(Bump)를 집어넣어 열압착(TC) 방식으로 연결하는 방식이 주류를 이루고 있다. 다만 HBM의 D램 적층 수가 16단·20단 등으로 점점 많아질수록 기존 TC 본딩도 적용이 어려워질 것으로 관측된다. HBM 패키지 두께가 최대 775마이크로미터(μm)로 제한돼 있기 때문이다.
때문에 업계는 칩과 웨이퍼의 구리 배선을 직접 붙이는 하이브리드 본딩을 대안 기술로 개발해 왔다. 해당 기술은 범프를 쓰지 않기 때문에, HBM의 패키지 두께를 크게 줄일 수 있다는 이점이 있다. I/O(입출력단자)를 더 밀도 있게 집적하고, 방열 특성도 높일 수 있다.
관련기사
- 한미반도체, 테스와 HBM 하이브리드 본더 개발 협약 체결2025.07.23
- 삼성전자, 'HBM4E 16단'서 하이브리드 본딩 도입 검토…샘플 평가 中2025.07.22
- 곽동신 한미반도체 회장 "HBM4·5도 TC본더로 간다…하이브리드 본더 더 비싸"2025.07.15
- 中, 하이브리드 본딩 특허 경쟁 '우위'…삼성·SK 크게 앞서2025.05.08
하이브리드 본딩은 이르면 HBM4E나 HBM5 등에서 본격적으로 적용될 것으로 보인다. 특히 삼성전자의 하이브리드 본딩 도입 의지가 가장 뚜렷한 것으로 관측된다.
한편 국내 장비업체인 한미반도체·한화세미텍도 하이브리드 본더를 개발하고 있다. 한미반도체는 최근 국내 또다른 장비기업 테스와 관련 장비 개발을 위한 협약을 체결했다. 한화세미텍은 올해 말 2세대 하이브리드 본더를 개발할 것으로 예상된다.












