IBM과 3M이 2년 뒤 상용화를 목표로 100개 이상의 칩을 수직으로 쌓을 때 사용되는 접착제를 공동개발하기로 했다. 상용화되면 기존 칩에 비해 1천배이상 빠른 속도를 낼 수 있다고 IBM측은 밝혔다. 이에 따라 PC와 서버는 물론 작은 면적에서 높은 성능을 내야 하는 모바일 기기에서 이 기술의 활용도가 높을 것으로 예상된다.
美지디넷·씨넷,EE타임스 등 외신은 7일(현지시간) 반도체기술을 가진 IBM과 접착제 전문업체인 3M이 3D칩상용화를 가능케 할 새로운 접착제 개발에 나섰다고 보도했다.
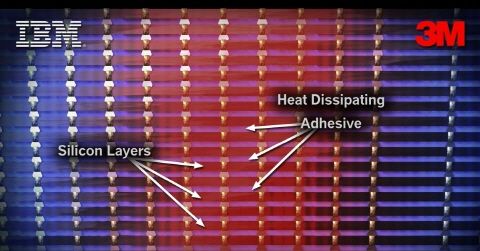
버나드 메이어슨 IBM연구소 부사장은 “빅블루(IBM의 애칭)와 3M은 각 영역에서 독자기술을 확보하고 있다”며 “3M은 나노 입자 접착기술을 확보하고 있다”고 말했다. 그는 또한 “접착제보다는 칩들을 고정시킬 수 있는 열관리 솔루션이라는 말이 더 정확한 표현”이라고 말했다. 칩을 수직으로 쌓아 올려 집적도를 높이는 방식은 ‘관통전극방식(Through Silicon Via, TSV)’이라 불리는 반도체 집적 방법이다.
보도에 따르면 IBM은 몇 개의 칩을 쌓아올리는 기술을 갖고 있지만 수백 개에서 수천 개에 달하는 칩을 집적하는 데는 어려움을 겪고 있었다. 칩들을 서로 붙이면서 발열량을 최소한으로 억제하는 성능 좋은 접착제가 나오지 않았기 때문이다. 이에 따라 IBM과 3M은 열을 전도하고, 집적회로의 발열량을 낮추는 기능을 가진 접착제를 개발 중이라고 말했다.
관련기사
- TSMC, 관통전극방식 3D칩 연내 양산2011.09.08
- 인텔 52년만의 반도체혁명···3D칩 등장2011.09.08
- 수천억 적자의 역설… '회계 착시' 걷어낸 K-팹리스 진짜 체력2026.04.17
- 신세계가 열흘만에 오픈AI 협업 계획 뒤집은 이유2026.04.17
대만 파운드리 업체인 TSMC는 올해 말까지 상용화를 목표로 22나노미터(nm)공정을 이용한 관통전극방식의 칩 패키징 기술을 개발할 예정이라고 지난달 발표한 바 있다.
한편 인텔은 지난 5월 실리콘 기판 위에 핀(Fin)이라고 하는 얇은 지느러미 모양의 구조를 세워 양면에 전자가 흐르도록 한 ‘트라이게이트’ 기술을 개발했다고 발표했다. 이 구조를 이용하면 1차선 도로에 고가도로를 지은 것처럼 두 배 이상의 전류가 흐르게 할 수 있다는 것이다.












