경박단소를 구현하고 가격 경쟁력을 높일 수 있는 패널레벨패키징(PLP) 공정이 차세대 반도체 패키징 기술로 떠오르고 있다.
최근 국내에서 PLP 기술이 첫 사업화됨에 따라 다양한 산업군에서 영향력을 확대할 전망이다.
15일 국내 반도체 업체 네패스는 세계 최초로 팬아웃-패널레벨패키지(FO-PLP) 공정을 적용한 제품 양산에 성공했다고 밝혔다. 회사는 기존 웨이퍼레벨패키지(WLP) 생산라인을 액정표시장치(LCD) 장비와 소재를 활용한 PLP로 전환해 청주 2캠퍼스에서 양산을 시작했다.
반도체 패키징이란 칩을 디바이스에 적용하기 위해 포장하는 기술이다. 이 때 칩의 입출력(I/O) 단자 배선을 기판에 연결하기 위해 바깥으로 빼는 과정이 포함된다.
PLP는 패키지용 인쇄회로기판(PCB)을 사용하지 않는 패키징 기술로 PCB 없이 웨이퍼 상태에서 패키지 공정과 테스트를 거쳐 칩으로 제작된 후 완제품에 적용한다. 기존 WLP 공정은 원형 기판에서 네모난 칩을 잘라내 둥근 모서리 부분은 쓸 수 없지만, PLP는 사각형 기판으로 작업해 수율 개선이 가능하다.
PLP 기술은 전력관리반도체(PMIC), 무선주파수(RF) 칩부터 모바일용 애플리케이션 프로세서(AP) 등 제품에 적용 가능하다. WLP 기술을 적용했을 때보다 소형화에 유리하고 반도체 입출력 단자 수를 늘려 성능을 높일 수 있다. 생산 비용은 WLP 공정 대비 20% 이상 절감된다.
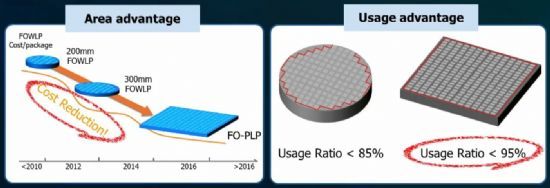
네패스는 이달부터 PLP 공정을 적용한 모바일용 시스템 반도체 양산을 시작했다. 시스템 반도체가 최근 스마트폰, 태블릿, 자동차 등 다양한 산업군으로 확대 적용되고 있는 만큼 첫 PLP 기술을 통해 패키지 산업의 패러다임을 주도한다는 목표다. 미국, 일본, 중국 등 고객사와도 협의를 진행하고 있다.
네패스 관계자는 "PLP는 기존 WLP의 우수한 물리적, 전기적 특성과 열 방출 특성 등은 유지하면서 대형 패널 상태에서 한 번에 다량의 칩을 패키징할 수 있다”며 “PLP 기반의 WLP 및 팬 아웃(Fan Out) 기술을 기반으로 한 패키지에서 모듈사업으로 영역을 확장할 것”이라고 말했다.
삼성전기도 올해 PLP 기술 사업화를 앞두고 있다. 회사는 삼성전자와 태스크포스(TF) 팀을 구축한 이후 지난해 2천632억원을 투자해 PLP 기술 개발에 나섰다. 회사는 올 하반기 초 PMIC 양산을 시작해 내년에는 모바일 AP 등 제품에도 확대 적용할 전망이다. 모바일 AP는 일반 IC보다 입출력(I/O)이 높은 만큼 동일한 PLP 기술이더라도 더 복잡한 기술을 필요로 해 개발 난이도가 높다.
관련기사
- 네패스, 차세대 반도체 패키징 PLP 세계 첫 상용화2017.05.16
- 삼성전기 “2Q 갤럭시S8으로 실적 대폭 개선 기대”2017.05.16
- 삼성전기 "올레드용 RFPCB 베트남서 2Q 본격 양산"2017.05.16
- 이윤태 삼성전기 사장 "전장·PLP 등 신사업 본격화"2017.05.16
삼성전기는 PLP 기술을 접목한 시스템인패키지(SiP) 사업을 강화해 적용 산업 영역을 확대한다는 방침이다. SIP는 하나의 패키지에 여러 시스템을 구축해 고집적을 구현함에 따라 전력 효율과 신호 속도를 개선하고 공간 효율성을 높여 세트 업체의 설계 자유도를 높인다. 삼성전기는 천안에 PLP 라인을 구축했으며 올해 수주 규모에 따라 추가 투자 가능성도 점쳐진다.
삼성전기 관계자는 “PLP 기술은 미세 회로 선폭 등 요소로 제품에 따라 기술 난이도가 조금씩 달라진다”며 “올해 사업화할 예정인 PLP 기술을 하이스펙 중심의 제품으로 적용 확대해 나갈 것”이라고 말했다.












